應用分享丨線光譜共焦傳感器驅動金線檢測效率升級
引線鍵合是半導體芯片封裝的核心工藝之一,通過微米級金屬導線將芯片與基板、封裝框架或其他外部電路連接,實現芯片內外部的電氣互連與信號傳輸。這一工藝應用廣泛,工藝質量直接決定芯片可靠性與性能。因此,在生產中對鍵合的金線進行快速、精確的三維形貌檢測至關重要。
本期我們將聚焦半導體封裝制程中的金線檢測,為您介紹埃科光電線光譜共焦傳感器如何有效提升該環節檢測效率。

應用難點
微米級檢測需求
金線間距、線徑僅數十微米,其形態缺陷(塌線、斷線等)與位置偏差(焊點偏移)均在微米級尺度,對檢測設備的分辨率與精度提出極高要求。
檢測效率瓶頸
傳統2D視覺檢測技術缺乏高度信息,無法獲取金線的高度、弧度輪廓等關鍵三維信息,難以準確識別塌線、弧高不一致等立體缺陷,誤檢率與漏檢率較高,嚴重影響質檢效率。
表面反光干擾
金線表面存在高反光干擾,且金線鍵合后焊盤表面可能存在殘膠等異物,傳統光學檢測對這類材質難以準確成像。
埃科光電方案:線光譜共焦傳感器SG系列
面對上述挑戰,埃科光電基于同軸式光譜共聚焦技術開發出SG系列線光譜共焦傳感器,可實現大視野高精度的金線工藝檢測方案。
高分辨率成像:微米級精度

線光譜共焦技術通過分析被測物反射回來的單色光波長信息,計算得到物體的高度信息,從而實現高精度、強抗干擾的三維測量。
埃科光電線光譜共焦傳感器輪廓數據數量達到4096個,且X軸輪廓數據間隔小至2.5μm,可生成高密度的真實三維點云數據。對于金線檢測,這意味著能精確測量每根金線的弧高、間距等關鍵尺寸。任何細微的塌陷、斷裂或形態異常,都會在三維輪廓中清晰顯現,從而實現對微米級缺陷的精準捕捉與量化分析。
大視野掃描:效率躍升

線光譜共焦技術可實現一條線上的所有點同步進行高精度測距,具備“線掃描”的高速特性,配合位移平臺就能實現快速三維檢測,有效提升檢測效率。
埃科光電全新推出的高分辨率線光譜共焦傳感器SG4050型號,在保持全量程掃描速度4.4kHz的同時(最高掃描速度18kHz),X軸測量范圍提升至20.4mm,Z軸測量范圍達到5mm,大幅減少單位范圍內掃描次數,驅動金線檢測效率升級。
同軸線共焦:強材質適應性

埃科光電線光譜共焦傳感器采用同軸光學設計,測量光和反射光沿相同的路徑傳播,避免出現遮擋盲區,可實現復雜材質表面的的零陰影掃描,對金線形態檢測有更好的適應性,同時不受金線反光的影響,實現卓越的掃描結果,重建高精度3D圖像。
雙型號選擇:適配細分需求
為滿足不同產線對效率與精度的差異化需求,埃科光電精心布局SG系列產品線:全新推出的SG4050型號與成熟的SG4025型號,可覆蓋側重點不同的金線檢測場景。
SG4025
提供4096個輪廓數據數量,X軸輪廓數據間隔達2.5μm,Z軸重復精度(鏡面)0.25μm,適用于對精細特征檢測要求更苛刻的場景。
SG4050
在維持高分辨率與高掃描速度的同時,X軸測量范圍(20.4mm)與Z軸測量范圍(5mm)進一步拓展,顯著提升檢測效率,適用于追求大規模、高效率在線全檢的產線。

應用效果
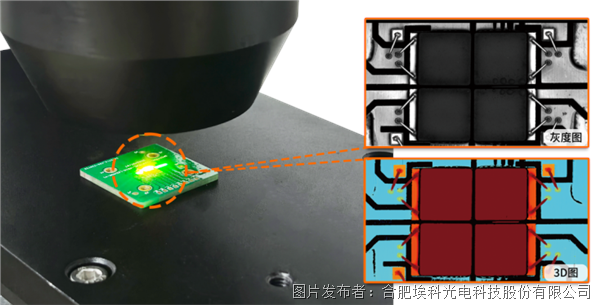
結語
隨著半導體工藝邁向后摩爾時代,視覺檢測是把控半導體產品質量的關鍵環節。埃科光電聚焦晶圓制備到封裝測試各工藝段,致力于為半導體行業全制程提供更高效、更精準的視覺檢測解決方案。
如需了解更詳細的應用案例、具體產品型號參數或定制化方案,歡迎后臺咨詢!
提交
看見視覺進化的力量! 埃科光電年度技術高光全景回顧
應用分享丨智能對焦系統實現TGV高效精準檢測
應用分享丨高階TDI線陣相機破局晶圓弱光高速檢測難題
行業應用丨埃科光電鋰電行業產品及解決方案
新品上市丨性能出眾,體驗升級!埃科UB系列小面陣相機實力進階








 投訴建議
投訴建議




